반도체 패키지 기판에 대하여
PCB는 보시는 것과 같은 인쇄 회로 기판을 말합니다.
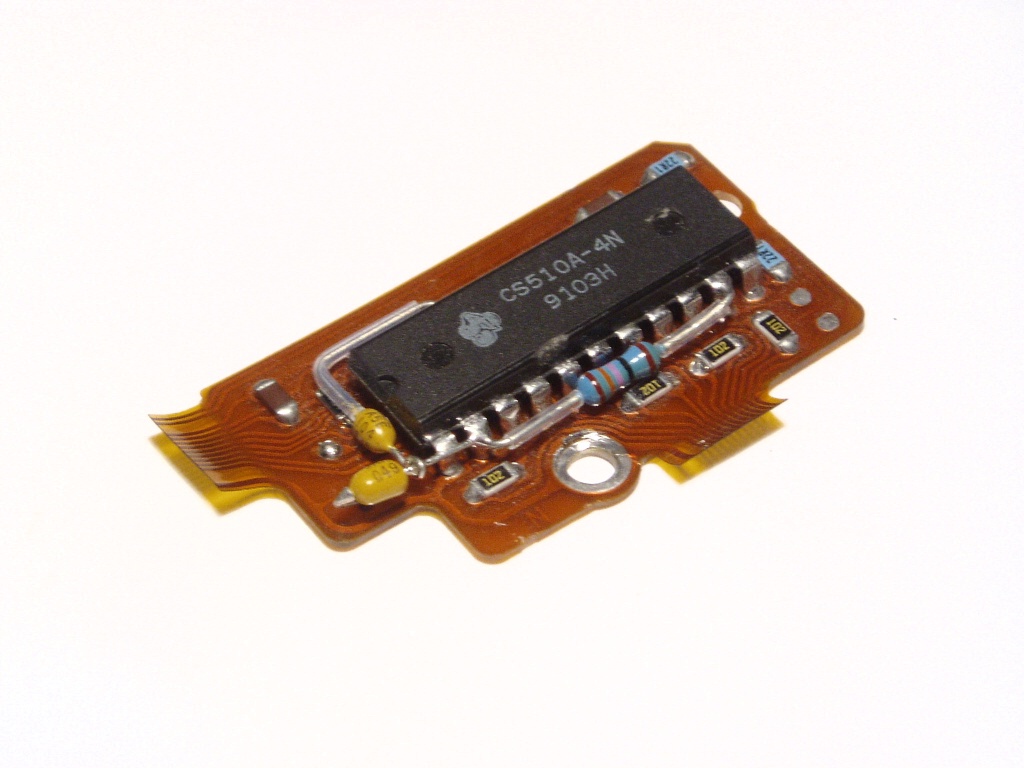
이 PCB는 크게 메인보드, 반도체 패키지 기판, FPCB로 구분이 되는데, 이 중 반도체 패키지 기판에 대해 주목해야 할 것 같습니다.
반도체 기술이 점점 미세화 되면서 파운드리 업체간 경쟁이 심화되고, 고성능 및 저전력 반도체 수요 급증에 따라 기술 구현을 위한 후공정의 중요성이 높아지고 있습니다.
일반적인 PCB는 HDI와 같이 전자기기의 메인보드 역할을 하는 기판으로 반도체를 비롯한 여러 부품들을 위에 실장하는 기판입니다. 반도체 패키지 기판은 반도체의 성능을 극대화하는데 초점을 맞춘 기판으로 메인보드와 반도체 칩 사이에 다리 역할을 하게 됩니다. 반도체 칩과 메인보드는 회로 선폭의 차이가 커서 반도체 기판을 사용해 연결하게 됩니다.
반도체 패키지 기판은 비메모리용과 메모리용으로 구분합니다. 비메모리용에는 FC-BGA, FC-CSP, SiP가 있고, 메모리용에는 MCP와 BOC가 있습니다. 그리고 반도체 패키지 기판은 반도체 칩과 기판을 연결하는 방식에 따라 저사양인 와이어본딩 방식과 고사양인 플립칩 방식으로 구분됩니다. 와이어본딩은 구리선을 활용해 칩과 기판을 연결하는 방식이며, 기판의 사양이 낮아서 주로 저성능 및 저부가가치 반도체 패키징에 사용됩니다. 와이어본딩 방식으로 연결하는 기판에는 MCP가 대표적이며 주로 스마트폰 메모리 패키징에 사용됩니다.
플립칩 방식은 구리선을 없애고 솔더 범프를 활용해서 연결하는 방식이며 빠르고 안정적인 신호 전달이 가능하다는 장점이 있어 고성능이 필요한 비메모리 기판으로 사용됩니다. 플립칩 방식에는 CSP, BGA, SiP, BOC가 있습니다. CSP는 Chip Scale Package로 반도체 칩과 기판의 크기가 비슷한 제품을 말하며, 기판을 작게 만들어야 하는 스마트폰 AP칩을 패키징하는데 주로 사용합니다. BGA는 Ball Grid Array로 반도체 칩보다 기판의 크기가 더 큰 제품을 말하는데, CPU나 GPU처럼 작게 만드는 것보다는 성능을 높이는데 초점을 둡니다. BGA는 반도체 기판의 면적을 넓히고 층수를 높여서 반도체 성능을 높이기에 유리한 방식입니다. 전방 시장은 주로 서버, 네트워크, PC, 전장용으로 쓰이며, 서버용이 가장 고부가가치 제품입니다. SiP는 System in Package로 통신용 반도체 패키징에 쓰이는 기판으로 단일 기판으로 사용될 경우 주로 스마트워치와 같은 웨어러블 디바이스의 메인보드를 대신해서 사용됩니다. 마지막으로 BOC는 일반적인 BGA 구조와는 다르게 반도체 칩이 거꾸로 실장되며 서버 및 PC용 메모리 패키징에 사용됩니다.
[반도체 기판의 밸류체인]
국내 반도체 패키지 기판을 만드는 업체에는 삼성전기, LG이노텍, 심텍, 대덕전자, 코리아써키트, 티엘비 등이 있습니다. 비메모리 중심의 삼성전기, LG이노텍, 대덕전자가 있고, 메모리 중심의 심텍, 코리아써키트, 티엘비로 구분할 수 있습니다.
클라우드 시장 성장에 따른 데이터센터 서버 수요가 급증하고, 서버용 기판은 PC용 대비 9배 이상 큰 면적이 필요함에 따라 FC-BGA를 통한 Chiplet 기술이 중요해졌습니다. 2020년 FC-BGA 중심의 기판 수요가 급증했는데 공급이 제한된 상황에서 가격이 상승하면서 관련 기업들의 실적이 좋았습니다. 서버 시장에서 FC-BGA 수요가 급증하면서 기업들의 증설이 잇따랐습니다. 삼성전기는 FC-BGA 증설에 약 1.9조원의 투자를 진행하고 있고, 1.3조원의 투자를 진행 중인 베트남 신공장은 올해 4분기부터 가동을 시작하게 됩니다. 삼성전기는 반도체 패키지 기판에서 올해 연간 1.7조원의 매출액을 전망하며, 이 중 FC-BGA의 매출액은 8천억을 전망합니다. 삼성전기는 PC향 FC-BGA에서는 글로벌 1위 업체이지만 서버향 FC-BGA에서는 후발주자로 올해 1천억원 정도의 매출액을 전망하고 있습니다. 글로벌에서 서버향 FC-BGA는 일본의 이비덴과 신코가 사실상 독점을 하고 있지만, 삼성전기도 FC-BGA 기술력에서는 글로벌 탑티어 수준이기 때문에, 베트남 신공장을 가동 이후에는 서버향 매출비중이 확대될 것으로 전망됩니다.
LG이노텍은 작년 2월에 FC-BGA 시장에 처음 진출해서 약 4천억원의 투자를 진행하고 있습니다. LG이노텍은 패키지 기판의 매출 비중이 전사에서 6% 정도로 낮지만 연간 1.3조원의 작지 않은 매출규모이며, 미세회로에 유리한 노광기술을 바탕으로 통신용 SiP와 밀리리터파 AiP에서는 글로벌 선두를 차지하고 있습니다. LG이노텍은 FC-BGA에서 후발주자로서 작년 시양산에 들어간 네트워크용에 이어 PC와 서버용에서 양산을 시작하고 안정적인 수율을 보여줘야 할 것입니다.
심텍은 메모리 기판의 매출 비중이 85%에 달하기 때문에 메모리 업황에 민감한 특징이 있습니다. 메모리 업체로부터 2~3개월 앞에 수주를 받기 때문에 메모리 업황 대비 선행하는 특징이 있습니다. 8월 기준으로 BEP 수준의 가동률 70%를 넘어서면서 3분기부터 흑자전환이 가능해보이며, 지속적으로 수주액이 증가되는 상황임을 봤을 때 전방 메모리 업황이 회복 중임을 확인할 수 있습니다.
[엔비디아와 패키지 기판]
엔비디아의 AI서버용 GPU인 A100과 H100을 TSMC의 CoWoS라고 하는 2.5D 어드밴스드 패키징에서 만들어지고 있습니다. 정확히는 A100은 TSMC의 7나노 공정, H100은 TSMC의 4나노 공정에서 만들어지고 있습니다. 그림을 참고하면 TSMC의 2.5D CoWoS 패키징을 보여주고 있으며, 가장 아랫단에 메인보드로는 MLB가 들어가는데 AI서버용 GPU에 쓰이는 18층 이상의 초다층 MLB는 현재 미국의 TTM와 이수페타시스만 공급이 가능한 것으로 알려져 이수페타시스의 주가가 급등한 상황입니다. 패키지 기판으로는 FC-BGA가 들어가며 현재 TSMC로는 이비덴이 공급 중이며, 삼성전자가 생산을 하게 되면 삼성전기와 대덕전자가 여기에 공급을 추진하고 있는 상황입니다.
최근 여러 기사를 참고해보면, 2023년의 TSMC의 CoWoS CAPA는 2022년의 2배 증가하며, 2024년은 다시 2배 증가한다고 말하고 있을 정도로 폭발적인 수요에 공격적인 증설을 진행하고 있는 상황입니다.
최근 기사에 엔비디아는 TSMC의 CAPA로 감당이 되지 않자, 삼성 파운드리와 다른 OSAT로 방향을 선회하려고 하고 있습니다. GPU 로직칩은 TSMC가 제조하고, 그 외 실리콘 인터포저, 어드밴스드 패키징, HBM을 묶어 삼성전자에서 원스톱으로 공급하는 것을 추진하고 있습니다.
현재 엔비디아의 H100을 기준으로 제조방식을 살펴보면, HBM은 SK하이닉스에서 만들고, GPU 로직칩과 실리콘 인터포저는 TSMC에서 만들고, TSMC가 CoW를 담당하면, WoS는 ASE가 담당하는 방식이며, FC-BGA는 이비덴이 공급하고 있습니다. CoW는 Chip on Wafer로 웨이퍼 위에 칩을 패키징하는 것을 말하고, WoS는 Wafer on Substrate로 기판 위에 위에퍼를 패키징하는 것을 말합니다. 현재 1차 공급 부족 상황에서 먼저 시도하는 것은 WoS를 담당하는 OSAT 업체를 다변화하는 것이고, 그럼에서 공급이 부족한 상황이면 삼성전자가 턴키로 공급을 추진하고 있습니다. 이렇게 되면 FC-BGA는 삼성전기가 공급을 할 수 있게 되어서 실질적인 가장 큰 수혜는 삼성전기로 예상합니다.
이런 상황에서 최근 삼성전자는 AMD에 HBM3와 2.5D 패키징인 아이큐브4(HBM을 4개 쌓아올린 것으로 2021년 양산 시작. 아이큐브8는 2024년 양산 예정)의 퀄 테스트를 모두 통과하고, 턴키로 수주를 받았다는 기사가 나오게 됩니다. 아직 삼성전자는 HBM3 양산을 못하고 있는 상황으로 9월에 양산을 시작하면서 엔비디아향 퀄 테스트를 통과할 것이라는 기대를 하고 있습니다.
결국, ChatGPT가 촉발한 AI서버 투자 붐은 엔비디아의 GPU 수요를 일으켰고, 첨단 패키징에 대한 투자 붐을 일으키고 있습니다. TSMC와 엔비디아라는 확실한 1위 업체가 존재하지만 폭발적인 시장의 성장세에 2위 업체의 전략 방향성이 중요해지는 시점이며, 삼성전자의 HBM과 삼성전자, 인텔의 첨단 패키징 투자에 주목을 해야될 시점입니다.
[삼성전기]
올해 주요 기판 업체들 주가수익률을 비교해보면, 삼성전기가 유독 부진했다는 것을 알 수 있습니다. 일본에 이비덴이 +74.0%, 신코가 +71.6%를 기록했고, 대만에 유니마이크론이 +47.5%를 기록한데 반해 삼성전기는 +12.0% 상승에 그쳤습니다. 올해 KOSPI 상승률이 +12%를 기록하고 있기 때문에 딱 지수 정도의 상승만 했다는 것을 알 수 있습니다.
삼성전기의 주가가 부진했떤 이유를 3가지로 정리해보면, 1) 중국 경기둔화 우려 2) 스마트폰,PC 수요둔화 우려 3) 서버향 FC-BGA 낮은 비중이 될 것 같습니다.
삼성전기는 전방산업에서 IT 수요를 많이 반영하는 특징이 있습니다. 전사에서 스마트폰과 PC향으로 매출 비중을 대략 구해보면 85% 정도 되는 것 같습니다. 광학통신솔루션 매출 비중이 34%인데 대부분 카메라 모듈이고 스마트폰향으로 삼성전자와 중국향으로 나가게 됩니다. 컴포넌트 매출 비중은 46%인데 이 중 90%가 MLCC이고, MLCC에서 80% 정도가 스마트폰과 PC향으로 볼 수 있습니다. 패키지솔루션 매출 비중은 19%인데 이 중 PC향이 70% 정도 차지합니다.
삼성전기는 중국 매출 비중이 과거 40% 수준에서 현재는 34% 수준으로 낮아지긴 했지만 여전히 중국에 대한 우려를 받고 있는 상황입니다. 하지만, 중국에 대한 우려와 스마트폰, PC 수요 둔화에 대한 우려는 현재 주가 수준에 충분히 반영된 리스크로 볼 수 있고, 현재 이익에 미치는 영향도 제한적입니다.
올해 예상 영업이익은 8600억 정도인데, 이 중 컴포넌트 5500억, 패키지솔루션 2200억, 광학통신솔루션이 900억 정도입니다. 스마트폰 수요에 가장 민감한 광학통신솔루션 쪽의 이익기여도가 10% 수준으로 낮아져 영향이 제한적입니다.
앞으로 이익 개선을 위해서는 MLCC와 패키지 기판으로 단순화해서 생각해볼 수 있습니다.
먼저, MLCC의 최근 수출데이터 개선 흐름이 긍정적입니다. 8월 들어 일평균수출금액과 수출단가가 모두 지난 달 대비 크게 개선되었습니다. MLCC의 일평균수출금액과 일평균수입금액을 비교해보면 모두 상승 추세인 점을 확인할 수 있습니다. 수출에서 중국이 차지하는 비중이 45% 정도 되는데 중국에서 전방 산업인 스마트폰과 PC의 주문이 회복 추세라는 점을 추정해볼 수 있고, 수출단가가 상승하는 점은 중국으로 나가는 전장용 고부가가치 제품의 수출이 증가하지 않나 추정해볼 수 있습니다. 수입에서 일본이 차지하는 비중이 50% 정도인데, 일본에 무라타, TDK 등 주로 전장용 및 산업용으로 들어가는 고부가가치 제품의 수입이 늘어나고 있다는 점을 추정해볼 수 있고, 수출과 수입 모두 개선 흐름이라는 점에서 전반적인 MLCC 업황이 개선되고 있다는 것을 추정해볼 수 있습니다.
삼성전기의 2분기 컨퍼런스콜을 통해서 확인해보면 MLCC의 현재 재고일수는 35일 정도로 과거 2021년 4분기에서 2022년 1분기에 업황이 가장 좋았을 때의 재고일수 30일과 비교하면 재고 상황이 많이 좋아졌다는 것을 의미합니다. 과거 재고일수가 저점을 기록하고 1개~2개 분기 이후에 Re-Stocking 수요가 성장했다는 점을 본다면 올해 4분기와 내년 1분기에는 가격과 수량 모두 크게 개선되는 흐름을 기대해볼 수 있습니다.
다음으로, 패키지 기판에서는 4분기부터 베트남 신공장에서 FC-BGA 가동이 시작되는데, 삼성전자가 AMD로부터 턴키 수주를 계약하고, 엔비디아도 삼성전자와 공급 논의를 하고 있는 상황으로 본다면 삼성전기의 FC-BGA 물량 확대는 충분히 가능성이 높다고 판단합니다.
삼성전기는 2분기 실적에서도 서프라이즈를 기록했고 3분기도 긍정적인 전망이 되는 상황에서 주가가 상승하지 못하는 이유는 전방 산업에 대한 수요둔화 우려를 많이 반영하고 있기 때문으로 보입니다. 이러한 리스크가 지워지는 시점에서 패키지 기판에 대한 긍정적인 흐름이 연결된다면 의미있는 주가의 전환점이 곧 있을 것으로 기대해봅니다.
용어정리
*PCB:
* HDI(High Density Interconnection): 정밀한 전자부품이 실장되어 슬림화, 고집적화와 고신뢰성 요구에 부응하도록 제작된 PCB입니다. 주로 서버, 데스크탑PC, 노트북PC, 태블릿 등에 사용됩니다.
(3) AI 반도체 시대 온다 / 기판·MLCC 물량확대 기대 수혜주는? / 상승의트리거 / 한국경제TV - YouTube